「新型プラズマ測定装置」
「測定原理と装置コンセプト」
本プラズマ測定装置は、半導体製造プラズマ装置等の材料プロセスプラズマに多用される絶縁壁内プラズマの測定技術として、電子放出可能な浮遊型プローブ法を提案し、絶縁状態でプラズマ量の測定が可能な測定装置を世界で初めて開発したものである。全てのプラズマ量が浮遊状態で測定可能で、プラズマ電子エネルギー分布測定もオプションによっては可能である。
また、SF6やO2等の実ガスプラズマでの測定も可能である。
図1(Fig.1)に示すように、従来の測定法(プローブ法)はプラズマから正味の電流を引き出して、その電流値の大きさからプラズマ量を計る方法であるが、この原理では電流のリターン電極(例えばプラズマ容器)が無い絶縁壁内プラズマの測定は不可能である。そこで、本測定装置では図1にあるように、プラズマから正味の電流を引き出さないで、電圧変化だけでプラズマ量を測定することを原理としている。
測定は数十kHzのパルス電圧で加熱したフィラメントプローブ(従来のエミッシブプローブ)の浮遊電位の変化を測定するものである。プローブが電子放出可能な状態でパルス電圧Offの点における浮遊電位VFがプラズマ電位の測定を可能にする。またパルス電圧がOnになるときの浮遊電位の変化量ΔVFにはプラズマ電子のエネルギーの情報が入っており、ΔVFの測定からプラズマ電子の温度と密度が測定でき、全てが絶縁状態で測定可能となる。更に、本測定法のプローブが
電子放出していないときの本プローブ法は従来のダブルプローブ法に近い。
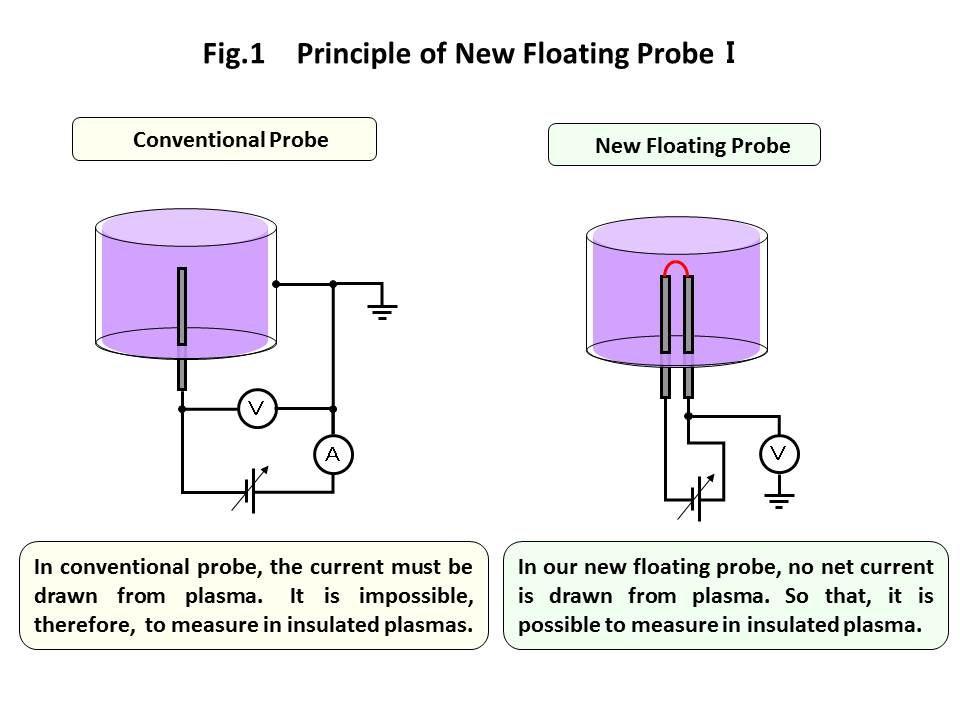
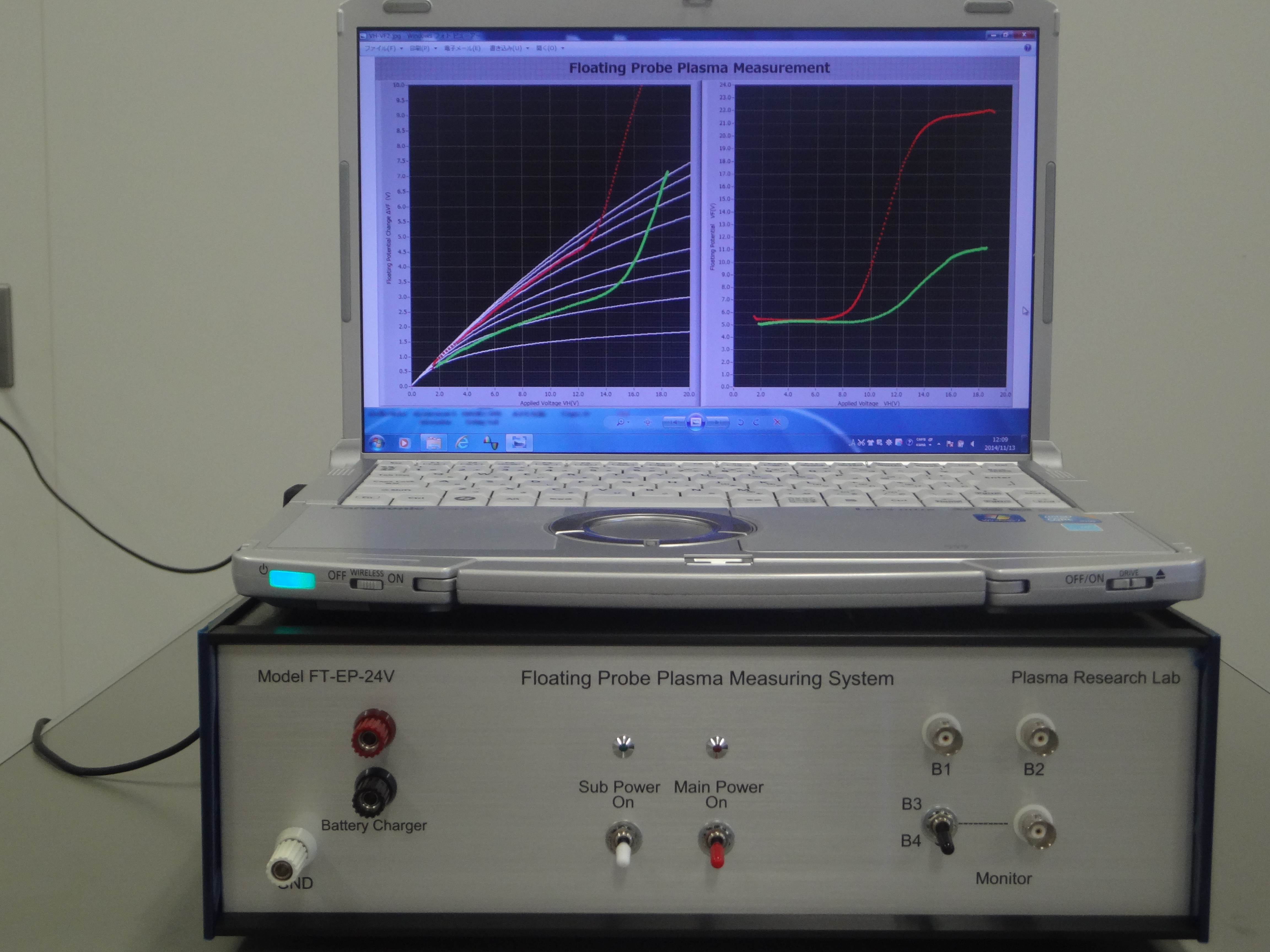
上図の写真は測定装置の実際を示した。生の測定データである前記ΔVFとVFの測定例がディスプレイ上に現れている。本プラズマ測定装置におけるプローブ実装では、オプションとしてΦ6のプローブ導入
が可能である。
[新型プローブによる測定例の説明]

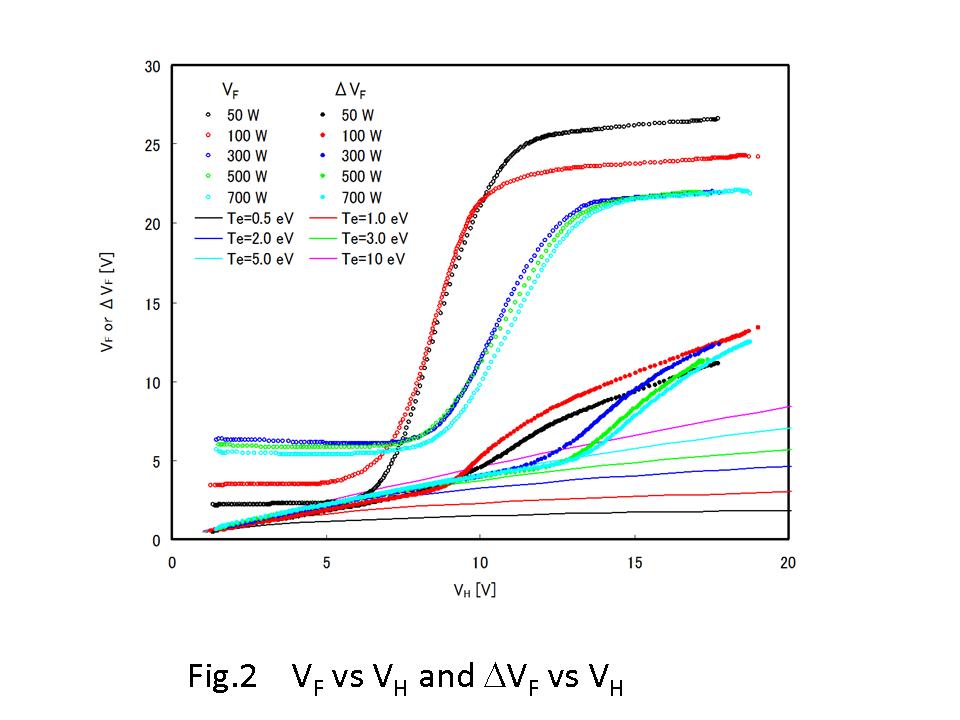
図2(Fig.2)には新型プローブ測定装置により実測された生データを示した。対象としたプラズマは圧力3mTorrのArICPである。
測定では、プローブの浮遊電位VFと浮遊電位の変化ΔVFがパルス波高値VHに対して直接測定される。図において、VFの測定はいずれの条件でも2つの特性電位(プラズマ電位、浮遊電位)が明確に得られている。一方、ΔVFからは電子温度と電子密度が得られる。
図2のような測定を繰り返すことにより、パラメータの分布を得ることが出来る。図3(Fig.3)には誘導結合Arプラズマを新型プローブで測定した電子温度、密度の結果を従来法(Langmuir Probe)による結果と比較して示した。両者の測定値には矛盾は無いことが分る。
新型プローブ測定装置はエッチングやCVDで多用される反応性プラズマの測定も可能であり、前掲のカタログに示されている。SF6エッチングプラズマにおいてΔVFを測定した結果を示した。図では同一の測定を250回繰り返した場合の
測定値を重ねて示してある。その結果、測定値は再現性よく安定的に行われていることが明確に分る。一方、同掲の酸素プラズマ中において同様に300回繰り返し測定した時の生データである。反応性の
高い酸素プラズマにおいても、再現性良く安定的の測定が行えることが示されている。
以上のように、新型プローブ測定装置は絶縁壁内プラズマの測定はもとより、半導体プロセスにおいて重要なエッチングプラズマやCVDプラズマなどにおいても安定的に動作させることが出来る。
更に、本プラズマ測定法においては、被測定量のΔVFがプラズマ電子全般のエネルギー情報を持っていることから、プラズマ電子エネルギー分布関数を測定することも可能である。電子エネルギー分布関数
の測定については以下の文献をご参照ください。
.